TGV 雷射加工研發服務
TGV 雷射加工研發服務:引領 AI 與先進封裝的玻璃基板關鍵技術
一、 什麼是 TGV 雷射加工?
主流技術對比:為什麼選擇雷射?
| 加工方式 | 優點 | 缺點 |
| 雷射燒蝕 (Laser Ablation) | 速度快、直接成孔 | 易產生裂紋 (Micro-crack)、碎屑殘留 |
| 雷射誘導蝕刻 (LIDE) | 孔壁光滑、高深寬比、無熱應力 | 製程步驟較多 (需搭配化學蝕刻) |
| 機械鑽孔 | 成本低 | 精度差、極易造成玻璃破裂 |
二、 我們的 TGV 雷射研發服務核心優勢
1. 超快雷射改質技術 (Picosecond/Femtosecond Laser)
2. 應力調控與緩衝解決方案
3. 客製化材料驗證
三、 TGV 技術的關鍵應用領域
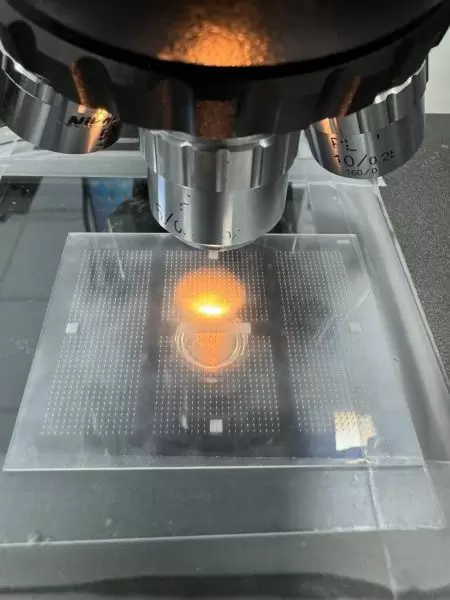
四、 常見問題 (FAQ)
Q:TGV 比起 TSV (Through Silicon Via) 的主要優勢為何?
Q:雷射加工如何避免玻璃破碎?
京碼——您邁向玻璃基板量產的最佳戰略夥伴
TGV (Through Glass Via) 是指在玻璃基板上製作垂直電性連接的技術。與傳統的 ABF 載板或矽中介層相比,玻璃具備更低的介電損耗、更佳的尺寸穩定性以及卓越的高頻傳輸特性,是 2.5D/3D 先進封裝、Micro LED 與 光學通訊 的核心解決方案。
在 TGV 的開發路徑上,研發團隊通常會面臨「孔徑微縮」與「成品率」的平衡挑戰。我們提供從模擬、打樣到製程優化的全方位研發服務:
利用皮秒或飛秒雷射進行非熱物理改質,精準控制玻璃內部的分子鍵結重組。
高深寬比: 支援 Aspect Ratio > 10:1 的極細深孔。
最小孔徑: 可達 $10\mu m \sim 80\mu m$ 的高精度鑽孔。
針對雷射加工後容易產生的殘留應力,我們研發專用的應力吸收緩衝層,有效抑制開孔邊緣的微裂紋(Micro-crack),提升後續 TGV Filling(金屬化填孔) 的可靠度。
不論是石英玻璃、硼矽玻璃或是高鋁玻璃,我們能針對不同材質的 CTE (熱膨脹係數) 進行製程參數匹配,減少熱失配導致的封裝失效。
AI 晶片與 GPU 封裝: 支援 Intel、NVIDIA 等次世代玻璃基板封裝需求。
5G/6G 高頻通訊: 玻璃的低損耗特性,適用於射頻前端模組 (RF FEM)。
Micro LED 顯示技術: 透明基板結合 TGV 實現高密度、高透光度的顯示驅動。
共同封裝光學 (CPO): 強化光學傳輸效率,縮短訊號傳輸路徑。
A:玻璃基板的電絕緣性遠優於矽,且在高頻環境下訊號損耗更低。此外,大面積玻璃基板的成本潛力與平整度,使其在大尺寸晶片封裝上更具優勢。
A:我們採用「雷射誘導深度蝕刻 (LIDE)」技術,先以雷射進行內部結構改質,再配合化學濕式蝕刻移除材料。這種方式不會直接「擊穿」玻璃,因此能保持結構完整,實現零裂紋加工。
面對 2026 年即將迎來的玻璃基板量產元年,技術落地的關鍵在於如何將實驗室的精密數據轉化為高良率的產線製程。
我們深知玻璃材質的脆弱性與加工挑戰,因此京碼不只是設備提供者,更是能提供完整解決方案的技術夥伴:
極致精準: 京碼擁有的獨家光學控制技術,能確保每一顆 TGV 孔位精確無誤。
跨域整合: 我們協助客戶優化從雷射改質到蝕刻後的結構穩定性,大幅降低研發成本。
量產橋樑: 透過京碼的專業引導,您可以縮短開發週期,確保製程從 R&D 階段完美銜接至大規模量產需求。
在先進封裝競爭激烈的關鍵時刻,選擇京碼,讓我們助您精準掌握玻璃基板的領先先機。
[立即聯繫我們,開啟您的 TGV 研發新賽道]

